作者 景嘉存储
辐射环境
空间辐射环境
空间环境中充满了来自浩瀚宇宙的各种粒子:质子、电子、α粒子、重离子等,这些粒子与电子元器件及材料发生相互作用,形成各种各样的辐照效应。其中对半导体集成电路影响较大的是电子能损导致的电离辐射效应。按照辐射带分布和辐射来源,空间辐射粒子主要分为地球俘获带、太阳宇宙射线和银河宇宙射线,如下图所示。

图 1 空间辐射环境
1.地球俘获带
地球俘获带是指在近地空间被地磁场俘获的高强度带电粒子区域,主要由电子、质子以及少量重离子组成。
2.太阳宇宙射线
太阳宇宙射线主要指太阳发生耀斑时喷射出的高能带能粒子,这些粒子在短时可达到很高强度,其能量一般在10~10,000MeV。由于太阳宇宙射线具有较高能量,强度又相当大,所以对空间电子系统危害也比较大。
3.银河宇宙射线
银河宇宙射线是宇宙空间中能量较高的带电粒子,主要是质子和α粒子,能量从几个MeV到几个GeV,但通量小。
地面环境
起源于宇宙射线与外大气层的相互作用的中子、α粒子和芯片材料中释放的放射性污染物是地面辐射效应的主要来源。宇宙射线与大气层中的氮原子和氧原子作用,释放出一系列的粒子(次宇宙射线),包括质子、质子和中子等。反过来,产生的粒子又具有足够的能量生成更多的粒子。从而使得宇宙射线可以穿透大气层,粒子数量先是增加,直到大气层的屏蔽效应占主导地位时,再逐步减少。
从电子器件的角度来看,大气层中子是影响最大的粒子,尽管其数量较少,但其足以触发芯片内部的核反应。
中子流具有一些奇特的特性,随海拔增加,在商用飞机飞行高度时达到峰值(比海平面的约高两个数量级)。因此,航空器要比地面电子设备易受大气层中子影响得多。中子流也会随纬度、气压和太阳活动等变化。作为参考,纽约的高能大气中子流约为13个中子/cm-2/hour-1。
芯片材料中释放的放射性污染物是地面辐射效应的另一重要来源,且随着制造工艺的提高,VLSI器件的特征尺寸(Feature Size)越来越小,其对VLSI的影响日益严重。在芯片中的典型排放等级约在10-3α/cm-2/hour-1量级。
辐射效应
按失效机理不同,可将辐射效应分为位移损伤剂量效应(DDD)、长期电离辐射累积引起的总剂量效应(TID)和单个高能粒子电离辐射引起的单粒子效应(SEE)。
位移损伤剂量效应可以导致半导体器件的永久损坏。在实际的空间电子系统设计中,采用具有一定质量面密度的材料,如铝或钽,对系统结构和辐射敏感器件进行辐射屏蔽,可以在一定程度上缓解总剂量效应对电子器件的影响,但是对于单粒子效应通过上述方法不能有效克服。本文主要讨论NAND FLASH的总剂量效应和单粒子效应。
高能粒子引起单粒子效应的过程相当复杂,不同粒子的作用机理也各不相同,但是引起单粒子效应的结果却是相同的。主要的单粒子效应类型如下表所示。
表 1 电子器件主要单粒子效应形式
|
类型 |
英文缩写 |
特征 |
|
单粒子翻转 |
SEU(Single Event Upset) |
存储型模块逻辑状态的翻转 |
|
单粒子多位翻转 |
SEMU(Single Event Multiple Upset) |
一个粒子入射导致存储单元多个位逻辑状态的改变 |
|
单粒子瞬态脉冲 |
SET(Single Event Transient) |
单个高能粒子导致瞬态电流在逻辑电路中传播,产生瞬时脉冲 |
|
单粒子功能中断 |
SEFI(Single Event Functional Interrupt) |
单粒子效应导致控制模块状态出错,引起器件功能的中断 |
|
单粒子闭锁 |
SEL(Single Event Latch-up) |
NPNP结构中的大电流再生状态 |
|
单粒子栅击穿 |
SEGR(Single Event Gate Rupture) |
栅介质因大电流流过而击穿 |
|
单粒子烧毁 |
SEB(Single Event Burnout) |
大电流导致器件烧毁 |
NAND FLASH辐射效应分析
NAND FLASH由主要由充电泵、MCU、行译码器、页缓存和浮栅单元组成,下面对其辐射效应分别展开分析。
充电泵
充电泵主要实现升压功能,为NAND FLASH编程提供高电压。试验表明,充电泵对总剂量效应非常敏感,充电泵电路中的PMOS管因辐射诱发的VTH偏移,导致充电泵输出电压持续下降。当辐射剂量超过10krad(Si)时,充电泵将无法提供充足的编程电压。

图 2 充电泵的总剂量效应
从上图可看出,当总剂量超过50krad(Si)时,会导致NAND FLASH编程失败,当总剂量超过100krad(Si)时,不管存储单元的初始值如何,均会被读作”已编程”状态。
MCU
NAND FLASH中的MCU容易遭受单粒子效应的影响,通常表现为单粒子功能中断。当粒子击中MCU,使其进入异常状态,即产生单粒子功能中断。单粒子中断表现为NAND FALSH的整个PAGE或BLOCK读错误、突然暂停或者意外进入测试模式等。单粒子功能中断可能需要重新上电或者复位才能恢复,有时甚至无需干预而自行恢复。
行译码器
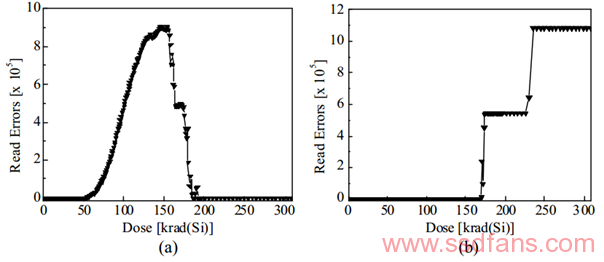
图 3 (a)编程状态的BLOCK (b)擦除状态的BLOCK
由上图可知,随着剂量的增加,读错误数也不断增加,这些错误是因为FG单元的VTH降低而引起的。而(a)中当剂量达到150 krad(Si)时,读错误数急剧下降,是因为此时行译码器已损坏。
浮栅单元
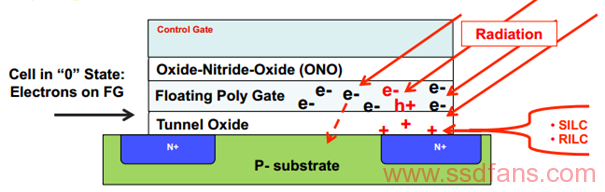
图 4 粒子辐射对浮栅单元的影响
浮栅单元是NAND FLASH中用于存储数据的基本单元,根据浮栅单元中电荷的数量来判定存储的数据值。粒子辐射会使浮栅单元中产生电子发射或电子-空穴对重组,从而导致浮栅单元中电荷量减少,当电荷量减少到门限值时,将会产生读错误。
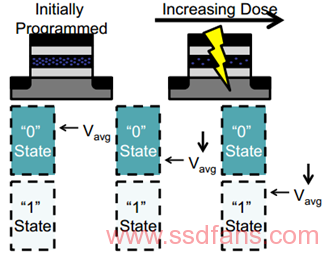
图 5 粒子辐射降低浮栅单元的电荷量

图 6 数据错误率随总剂量增加而增加
单个粒子对浮栅单元的影响与总剂量效应不同,因为其能量是由每个粒子释放的,其量级较小。因此,每个粒子可能在局部产生较大的影响。

图 7 辐射后VTH的空间分布示意图
上图为FLASH中的浮栅全部编程为’1’,然后用2×107 I ions/cm进行辐射,VTH产生偏移的场景。其中,每个方块表示一个FG。由于辐射总会使FG中的电荷减少,因此,ΔVTH恒为负值。
页缓存
页缓存主要用于临时存放从PAGE中读取到的数据,然后输出到FLASH管脚。页缓存的结构与SRAM类似,易于受SEU影响,从而产生数据位翻转。
解决措施
多次写入
为了解决浮栅单元中电荷因辐射减少的问题,可采取对NAND FLASH多次写入的方法,以增加浮栅的电荷量。从下图可看出,通过多次重复写入,可以提高产生数据错误所需的剂量阈值。
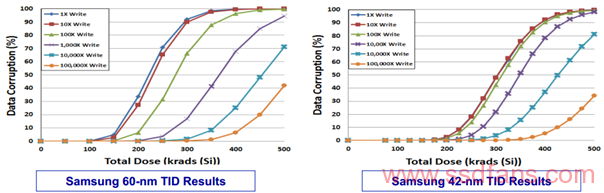
图 8 粒子辐射对浮栅单元的影响
改进工艺
最根本的办法是采用更好的半导体工艺,提高NAND FLASH的抗辐射能力,例如SOS或SOI工艺,通过增加电路单元间距以减少辐射能量的影响范围。但是,采用SOS或SOI工艺需要重新设计NAND FLASH芯片,往往耗资巨大。
下图是TCS开发的一款辐射加固级NAND FLASH,容量为8Gb,陶瓷封装,可以耐受50krad (Si)的剂量,符合MIL-STD-883标准。

图 9 辐射加固级NAND FLASH
试验筛选
NASA工程师研究发现即使是同一批次的芯片在相同的辐射环境下,也会表现出不同的特性。因此,最经济可行的办法就是采用COTS进行筛选。鉴于成本原因,对COTS NAND FLASH进行试验筛选是切实可行的办法,并已广泛应用于空间设备。
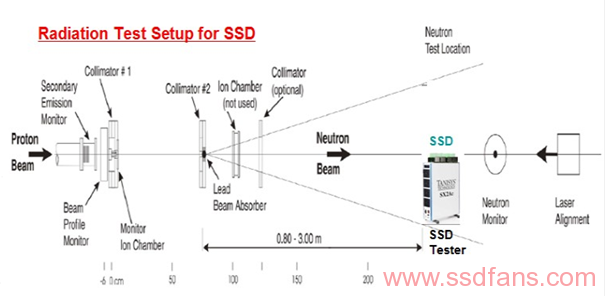
图 10 SSD辐射试验
作为DUT的SSD放置在真空腔中,粒子束经过加速后对SSD进行轰击,以模拟辐射效应对SSD的影响。为了便于粒子穿透器件,所有DUT器件均要进行蚀刻,以去掉其封装。下图为蚀刻后NAND FLASH。
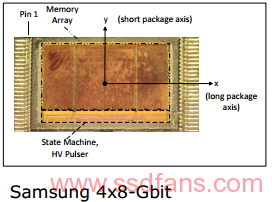
图 11 蚀刻后的NAND FLASH
结论
虽然NAND FLASH已经在空间设备中取得一些应用,但由于空间应用任务的特殊性,空间电子器件一般均落后于主流器件水平二到三代。由于NAND FLASH的复杂性,NAND FLASH的辐射效应在机理和加固措施研究上均处于比较初级的阶段,随着芯片工艺的进一步发展,其辐射将就会更加严重,对NAND FLASH的抗辐射加固以推进其在空间的应用仍是一个开放的课题。
参考文献
[1]邢克飞.
星载信号处理平台单粒子效应检测与加固技术研究[D]. 国防科技大学.
[2]贺兴华. 空间微小型信息处理系统单粒子效应及其加固技术研究[D]. 国防科技大学.
[3]Rino Micheloni et al. Inside NAND Flash memories[M]. Springer Press.


